Technologies Available for License
Categories: advanced materialsnanotechnology
2015-029: Block Copolymer Blends for Complex, High Resolution Lithographic Patterning
Invention: 2015-029
Patent Status: U.S. Patent Number 10,126,652 was issued on November 13, 2018
For technical and licensing related questions, email tcp@bnl.gov.
Summary
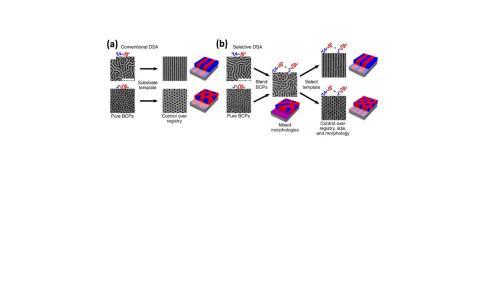
Figure: Conventional (a) and selective (b) directed self-assembly.
Directed self-assembly (DSA) of block copolymers is an emergent technique for nano-lithography, but is limited in the range of structures possible in a single fabrication step. Brookhaven researchers here defined a new lithographic patterning approach that enforces coexistence of multiple, aligned block copolymer morphologies within a single patterning layer. A blend of lamellar and cylinder forming block copolymers assembled on specially designed surface chemical line gratings, leading to the simultaneous formation of coexisting ordered morphologies in separate areas of the substrate. This technique extends the conventional DSA approaches to furthering the role of the template guiding pattern in influencing the block copolymer assembly process, enabling formation of multiple nanoscale patterns from a single blended block copolymer thin film.
Description
A method for creating patterns on a surface of a substrate includes plasma cleaning a substrate, depositing a polymer brush onto a surface of the substrate, depositing a resist layer, optionally annealing the resist layer, forming grating patterns onto the resists, developing the grating patterns, etching to transfer the grating pattern to the polymer brush, depositing block copolymer films onto to the substrate. The resulting film may be annealed.
Benefits
Brookhaven's new approach provides an easier solution to create multiple patterns on surfaces with dimensions in the range of 5-50 nanometers. This size range typically require specialized equipment such as electron beam lithography a technique that has the required resolution but lacks the high throughput necessary for manufacturing. The blended block copolymer self-assembly approach described here has the right combination of resolution and speed to be manufacturable.
Applications and Industries
The potential application includes large area nanopatterning for microelectronics device manufacturers.
Journal Publication & Intellectual Property
- US 10,126,652 B2 (.pdf)
- Selective directed self-assembly of coexisting morphologies using block copolymer blends (.pdf)
Press Releases
Contacts
-

Poornima Upadhya
Manager Technology Transfer & Commercialization
Technology Commercialization
(631) 344-4711, pupadhya@bnl.gov
-

Avijit Sen
IP Licensing & Commercialization
Technology Commercialization
(631) 344-3752, asen@bnl.gov




